Planaritätsprüfung beim Hybrid Bonding
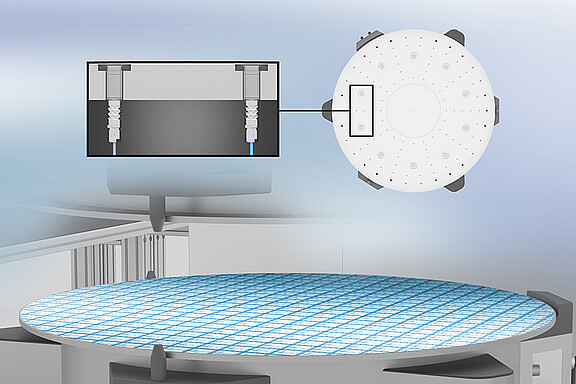
Beim Hybrid Bonding in der Halbleiterfertigung ist eine exakte Planarität der Wafer entscheidend für stabile Bondingprozesse. Kapazitive Abstandssensoren ermöglichen die hochauflösende Messung von Formabweichungen auf Wafern und liefern die Messdaten für eine adaptive Nivellierung der Bondingeinheiten.
„Hybrid Bonding“ ist eine fortschrittliche Verbindungstechnologie in der Halbleiterfertigung, bei der zwei Wafer oder Chips (Dies) über Kontaktflächen aus Kupfer direkt miteinander verbunden werden. Dadurch entfallen herkömmliche Lötbälle. Beim modernen Die-to-Wafer (D2W) oder Wafer-to-Wafer (W2W) Hybrid Bonding ist die Echtzeit-Planaritätsmessung der entscheidende Faktor für einen zuverlässigen Prozess.
Kapazitive Abstandssensoren spielen dabei eine zentrale Rolle, indem sie die berührungslose Messung von Formabweichungen auf Wafern ermöglichen – etwa durch Durchbiegung, Verwindung oder lokalen Verzug. Dadurch kontrollieren die Sensoren die Planarität der Wafer und liefern essenzielle Messdaten zur adaptiven Nivellierung der Bondingeinheiten.
Inline-Planaritätskontrolle vor dem Bonding
Je nach Messaufgabe tasten Sensorarrays die Oberfläche des oberen und unteren Wafers ab und erfassen lokale Erhebungen, Vertiefungen, Neigungen oder die gesamte Durchbiegung. Die Messdaten fließen in eine aktive Positionskorrektur der Wafer-Stages ein. Werden Höhenunterschiede erkannt, kann die Bondeinheit zum Beispiel über Piezoaktoren oder Präzisionsachsen in Z-Richtung exakt ausgerichtet werden. Für sehr kleine Chips werden auch segmentierte Flächen auf dem Chuck genutzt, die lokal nivelliert werden können.
Dank der vakuumtauglichen Ausführung können die kompakten Sensoren in nahezu allen Anwendungsbereichen eingesetzt werden.